基于PS球自组装技术的GaN纳米柱阵列ICP刻蚀工艺研究论文
2024-06-01 10:48:34 来源: 作者:zhoudanni
摘要:选用蓝宝石衬底上生长的P型氮化镓为材料,通过自组装技术制备的PS球为掩膜,采用感应耦合等离子体(ICP)干法刻蚀的方法来制备形状规则、周期均匀的纳米结构。在制备过程中,氮化镓纳米结构的形貌受诸多因素的影响,例如胶体球掩膜自组装的形貌,ICP刻蚀所通入的气体类型、气体比例、刻蚀功率源、刻蚀时间等。系统地研究了刻蚀过程中通入的气体类型、气体比例和刻蚀功率源、刻蚀时间对氮化镓纳米结构形貌的影响,并进行调整优化。
摘要:选用蓝宝石衬底上生长的P型氮化镓为材料,通过自组装技术制备的PS球为掩膜,采用感应耦合等离子体(ICP)干法刻蚀的方法来制备形状规则、周期均匀的纳米结构。在制备过程中,氮化镓纳米结构的形貌受诸多因素的影响,例如胶体球掩膜自组装的形貌,ICP刻蚀所通入的气体类型、气体比例、刻蚀功率源、刻蚀时间等。系统地研究了刻蚀过程中通入的气体类型、气体比例和刻蚀功率源、刻蚀时间对氮化镓纳米结构形貌的影响,并进行调整优化。利用扫描电子显微镜(SEM)对氮化镓进行的形貌分析表明:(1)随着刻蚀功率源和刻蚀时间的增大,掩膜层PS球的尺寸会随之减小使得刻蚀得到的纳米结构直径减小;(2)氮化镓纳米结构的形貌、刻蚀速率受到刻蚀通入的气体类型和比例影响,在Ar和CF4或SF6的组合气体作用下刻蚀速率相对非常缓慢,最高为15 nm/min,而Cl2和BCl3的组合气体作用速率可达到150 nm/min。
关键词:PS球自组装,ICP刻蚀,GaN纳米柱,刻蚀速率
0引言
氮化镓(GaN)因其具有3.4 eV的直接带隙、高迁移率和优异的热稳定性等优异的光电性能而备受关注[1]。
GaN纳米结构是一种非常有前途的材料,可用于制造具有优异性能的器件,如LDs[2]、LEDs[3]、太阳能电池[4]、传感器[5]和压电纳米发电机[6]等。近年来,有序阵列结构因其尺寸统一、排列整齐的特性不仅对于性能和稳定性有着显著提升[7],还经常伴随着出现一些值得探究的物理新现象,使得有序纳米阵列结构逐渐成为人们研究的热点。随着纳米科学技术的发展,人们已经能通过不同的方法合成GaN纳米结构材料,并且在一定程度上调控其微结构,进而提升材料的性能。目前制备氮化镓纳米柱的工艺主要分为“自上而下”和“自下而上”两种方法。例如通过分子束外延形成氮化镓纳米柱[8];通过金属有机化学气相沉积(MOCVD)[9]或氢化物气相外延(HVPE)[10]在图形化衬底上选择性生长GaN;垂直排列和多面化的氮化镓纳米棒在氮化镓层上用图案化的SiO2模板制备[11]。上述方法是所谓的“自下而上”技术,它们通常在大小、长度和方向上分布广泛,对目标材料的微观形貌有所限制,同时对于形貌的调控比较困难。与自下而上的合成相反,自上而下的方法,如反应离子刻蚀(Reactive ion etching,RIE)[12],离子束刻蚀(Ion Beam Etching,IBE)[13]和电感耦合等离子体刻蚀(Inductively Coupled Plasma,ICP)[14-16],拥有更经济和广泛的控制。对于RIE/IBE/ICP比较,RIE具有最低的蚀刻率,这是由于最低的离子密度和最高的操作压力;IBW刻蚀的选择比差,物理损伤大;而IC P在蚀刻过程中提供高等离子体密度,能够产生更多的化学蚀刻成分和更快的蚀刻速率,具有相对高的选择比以及更小的刻蚀损伤[17]。如果精确控制ICP功率、RF功率、工作压力和流量等蚀刻条件,可以获得较高的蚀刻速率和各向异性剖面。
纳米球刻蚀技术[18]由因其操作简单和成本低等优点,目前已经被广泛用于有序纳米线阵列[19]、有序纳米网格阵列[20]、有序纳米柱阵列[21]、量子点晶体[22]和有序纳米孔阵列[23]等有序结构的研制和推广中。纳米球刻蚀技术中常用聚苯乙烯(PS)纳米球作模板,通过气液界面法在衬底上密排单层的PS纳米球(纳米球之间呈六角紧密周期性排列),通过IC P干法刻蚀修饰密排的PS球使其直径缩小而位置不变,就构建成非密排且周期有序分布的PS纳米颗粒模板。在此基础上再进行二次ICP干法刻蚀就可以制备出有序纳米柱阵列结构。通过调整模板中PS纳米球的初始直径和直径减小量,能有效调控有序纳米柱阵列的周期、间隙[24]以及纳米柱的直径。
本文研究了GaN材料在Cl2和BCl3/Ar和CF4/Ar和SF6电感耦合等离子体中的蚀刻特性以及对聚苯乙烯胶体球的蚀刻选择性。分析了氮化镓蚀刻速率与气体组合成分和刻蚀时间的关系。通过场发射扫描电子显微镜(SEM)来表征GaN纳米结构的形貌,讨论了GaN纳米柱阵列制备过程中的优化蚀刻工艺。
1实验
基于PS球自组装法制备GaN纳米阵列工艺流程如图1所示。首先将经过标准清洗的GaN衬底进行亲水化改性处理,然后通过自上而下的方法自组装制备直径统一的聚苯乙烯单层膜,并紧密有序地吸附在GaN衬底上;最后通过感应耦合等离子体刻蚀制备出周期统一、高度有序的GaN表面纳米阵列结构。
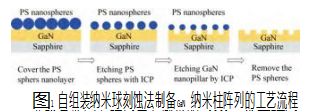
选择某蓝宝石衬底单面抛光的P型GaN作为衬底,PS球平均直径为300 nm和500 nm,浓度为2.5%。GaN基片依次经过异丙醇、无水乙醇、超纯水各超声清洗5min,放入过氧化氢水溶液中,并在温度为60℃的条件下水浴10 min来完成GaN基片表面的亲水处理,然后通过氮气将样片吹干。利用自上而下的自组装法制备单层紧密排布PS纳米球薄膜的步骤是:首先将载玻片和培养皿清洗干净,在培养皿中加入适量的去离子水,然后将载玻片一端放入培养皿中,另一端位于培养皿侧壁之上,其次将PS纳米球与甲醇按一定比例配置的混合溶液超声混合均匀后,用移液针管取一定量的纳米球溶液缓慢匀速滴在倾斜的载玻片上。使其缓慢流向液面,并在液面均匀散开自组织形成单层紧密排布的PS纳米球薄膜;最后将洗干净的GaN基片放入薄膜底下再缓慢提起完成GaN基片上单层密排PS纳米球掩膜层的制备。
待样品自然干燥后放入ICP刻蚀真空腔依次进行两次等离子体刻蚀。第一次是调整PS球的尺寸,采用Ar和O2,流量分别为10 sccm和50 sccm,ICP功率为100 W,RF功率为200 W,腔室压强为5Pa,刻蚀时间为45~60 s来完成PS球掩膜层的修饰。第二次是刻蚀GaN纳米柱,通入不同气体比例的混合物,设置ICP功率,RF功率,腔室压强和刻蚀时间来完成纳米阵列的刻蚀。最后用甲醇、超纯水依次各超声10 min去除PS球掩膜后,在样品上留下纳米柱阵列。最后样品的表面形貌由场发射扫描电子显微镜来表征。
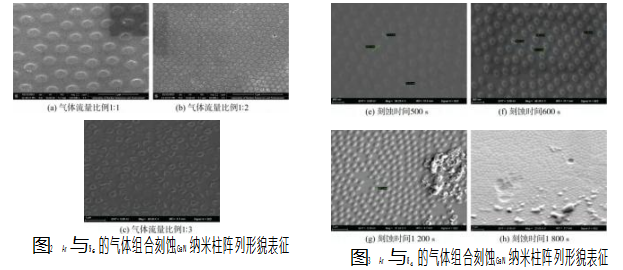
2不同气体类型对GaN纳米柱阵列的影响
通过改变刻蚀气体类型、气体流量比例、刻蚀的时间和功率大小,对得到的GaN纳米柱深度及其表面形貌有一定的影响。因此本文实验针对改变这些变量分别进行实验探究这些参数在干法刻蚀GaN纳米阵列中的影响趋势。实验探究了Ar和SF6、Ar和CF4、Cl2和BCl3三种不同气体组合对于氮化镓材料制备纳米阵列的干法刻蚀效果。
2.1 Ar与SF6的气体组合刻蚀GaN纳米柱阵列
图2所示为Ar与SF6组合3种不同气体配比刻蚀GaN纳米柱阵列的SEM图,PS球直径为500 nm,二次刻蚀条件中ICP功率源、RF功率源、压强与时间均相同,分别为100 W、200 W、5 Pa和400 s。其中气体流量比例分别为Ar:SF6=1∶1、1∶2、1∶3,气体总量保持在40 sccm左右。从图中可以看出采用Ar与SF6的气体组合刻蚀GaN纳米柱阵列的刻蚀影响速率非常缓慢,刻蚀深度难以测量,同时随着SF6在气体总量中比例的增大,纳米阵列的形貌逐渐走向无规则、无周期。因此对于通入Ar与SF6的气体组合刻蚀GaN纳米柱阵列的最佳刻蚀气体比为1∶1。
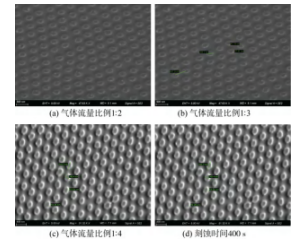
2.2 Ar与CF4的气体组合刻蚀GaN纳米柱阵列
图3(a)、(b)、(c)为Ar与CF4组合3种不同气体配比刻蚀GaN纳米柱阵列的SEM图,PS球直径为500 nm,二次刻蚀条件中ICP功率源、RF功率源、压强与时间均相同,分别为100 W、200 W、5 Pa和400 s。其中气体流量比例分别为Ar:CF4=1∶2、1∶3、1∶4。可以看出纳米柱阵列形貌与刻蚀深度在比例为1∶4时表现最佳。图3(d)、(e)、(f)为Ar与CF4气体组合3种不同刻蚀时间刻蚀GaN纳米柱阵列的SEM图,PS球直径为500 nm,二次刻蚀条件中ICP功率源、RF功率源、压强与气体流量比例均相同,分别为100 W、200 W、5 Pa和1∶4。其中刻蚀时间分别为400 s、500 s、600 s。测量结果显示在45°斜台上分别为53.54 nm、86.18 nm和100.2 nm,其实际刻蚀深度为53.54×、2=75.71 nm、86.18×、2=121.87 nm和100.2 nm×、2=141.70 nm,可以看出刻蚀深度随着时间的增加而提高,在刻蚀时间条件为600 s时纳米柱阵列的形貌与刻蚀深度表现最佳。
为探究纳米柱阵列形貌的极限,在上述条件下将时间条件增大一倍至两倍,结果如图3(g)、(h)所示,刻蚀条件中ICP功率源、RF功率源、压强与气体流量比例均相同,分别为100 W、200 W、5Pa和Ar∶CF4=1∶4。
其中刻蚀时间分别为1200 s和1800 s。可以看出在1200 s刻蚀时间下纳米柱阵列几乎不成规则周期形貌,1 800 s刻蚀时间下纳米柱阵列几乎消失,这是因为随着刻蚀时间的加长,对PS球刻蚀程度较大的情况下,PS球无法再起到掩膜作用,刻蚀的GaN无法保持完全垂直刻蚀甚至刻蚀出现截断,使得刻蚀深度较小,最终形成不规则形貌。
显然SF6与CF4作为氟性气体对GaN薄膜具有一定的刻蚀效果,但刻蚀速率都比较缓慢,相比于SF6与Ar的气体组合,CF4与Ar的组合制备纳米柱阵列形貌更为稳定,可以维持PS球相对较好的球体形貌。与此同时SF6、CF4也都对作为掩膜作用的PS球有着不同程度的影响,因此在缓慢的速率下去增加刻蚀时间,PS球掩膜作用会随之变形甚至消失而无法作为掩膜作用。
2.3 Cl2与BCl3的气体组合刻蚀GaN纳米柱阵列
图4所示为Cl2与BCl3组合气体在类似同等刻蚀条件下3种不同气体配比刻蚀GaN纳米柱阵列的SEM图,由于前期实验刻蚀深度均较小,为更清晰地观测纳米柱形貌,之后的实验采用PS球直径为300 nm,二次刻蚀条件中IC P功率源、RF功率源、压强与时间均相同,分别为100 W、200 W、5 Pa和300 s。其中气体流量比例从BCl3∶Cl2=1∶5到BCl3∶Cl2=1∶9,形貌结果图均为图4(a)类似形貌,这是由于氯基对GaN材料和PS球的刻蚀速率比氟基快得多,在同等刻蚀条件下PS球掩膜层作为掩膜的时间非常短,随着刻蚀时间PS球直径逐渐缩小直到消失,使得氮化镓纳米阵列从柱状向圆锥形貌变形,整体刻蚀程度不均匀,呈分散形貌。在此条件基础上调整刻蚀功率源和时间参数得到图4(b)、(c)的GaN纳米柱阵列的SEM图,PS球直径为300 nm,二次刻蚀条件为混合气体比BCl3∶Cl2=1∶8,射频功率为100 W,平板功率为70 W,腔室压强为0.6 Pa,刻蚀时间为60 s。
显然使用Cl2与BCl3的组合气体刻蚀以PS球为掩膜层的氮化镓可以得到整体周期和高度统一,排列有序,形貌规则的氮化镓纳米柱阵列。从图中测量数据可以得出刻蚀直径为170 nm左右,刻蚀深度在45°斜台上为110 nm左右,其实际刻蚀深度为110×、3=155.56 nm。同时可以得出使用Cl2与BCl3的组合气体刻蚀氮化镓纳米阵列1 min就可以达到Ar与CF4的气体组合刻蚀10 min的刻蚀速率,大大提升了刻蚀效率。
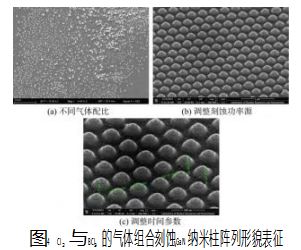
3 GaN纳米柱阵列的光学特性
本文中选择Lumeical FDTD软件进行纳米阵列光反射效果的模拟,时域有限差分(FDTD)数值模拟方法被认为是模拟纳米阵列结构反射特性最准确、最简便、最严谨的方法之一。

首先根据如图5所示建立三维纳米阵列模型并进行光学仿真,定义蓝色部分为厚度为200 nm的蓝宝石衬底,在其衬底之上的红色部分是厚度为100 nm的薄膜以及圆柱,薄膜及圆柱的材料均为氮化镓,其中圆柱部分表示纳米阵列的组成单元。

设置纳米结构的高度为200 nm,直径分别为100、150、200、250、300 nm以及无纳米阵列的平面结构,通过仿真得到如图6所示的光学反射率。从仿真结果可以看出,在仿真波段范围300~2 000 nm内,由于纳米阵列的作用,GaN反射率在40%以下,在300~1 300 nm波段范围内,反射率甚至几乎为0,吸收率达到最高。在仿真波段范围1300~2 000 nm内不同直径对比显示,直径为150 nm时,反射率相对最低,吸收率变化明显,说明此阵列发生共振吸收最明显,因此选择直径150 nm作为制备纳米阵列的尺寸。相应的纳米阵列内部的电场和磁场的分布如图7所示,观察电场和磁场的分布情况,在纳米柱内部,电场和磁场分布呈环形分布,说明发生了共振现象,而不同直径纳米阵列内部电、磁场分布的不同,说明纳米阵列的光学特性与直径有直接关系。

4结束语
本文研究了ICP刻蚀GaN的工艺参数,包括刻蚀气体类型、气体比例、功率源以及刻蚀时间对刻蚀GaN纳米柱阵列的影响。首先利用自上而下的气液界面法制备出形状、尺寸精确可控以及分布整齐紧密的聚苯乙烯胶体球掩膜层,然后进行两次ICP干法刻蚀。第一次刻蚀是修饰PS球的尺寸使其非紧密排布,为刻蚀出纳米柱做基础;通过第二次刻蚀制备出直径为150 nm,周期为300 nm,深度为150 nm的GaN纳米柱阵列。详细分析了不同刻蚀气体组合和不同刻蚀时间对GaN材料的刻蚀速aN材料刻蚀气体为Cl2和BCl3的气体组合以及最适合的刻蚀条件。
然后通过FDTD光学仿真软件建立模拟结构测试光反射效果得出了表面带有纳米柱阵列结构的GaN的反射率得到明显的降低,在半导体光电子器件和光电发射领域具有非常广阔的应用前景。
参考文献:
[1]Lin Z,Xiu X,Zhang S,et al.Arrays of GaN nano-pillars fabricated by nickel nano-island mask[J].Materials Letters,2013108.250-152.
[2]on Fliv p rndt iak S,et al.Multi-quantum-well,nanowire hetercstructures fgr wavelength-controlled lasers JNature 1 materials,2008 7 9):701-706.
[3]Zhong Z,Qian F,Wang D,et al.Synthesis of P-type gallium nitride nanowires for electronic and photonic nanodevices[J].Nano Letters,2003,3(3):343-346.
[4]Tang Y B,Chen Z H,Song H S,et al.Vertically aligned P-type heterojunction photovoltaic cells[J].Nano letters,2008,8(12):4191-4195.
[5]Dobrokhotov V,McIlroy D N,Norton M G,et al.Principles and gold nanoparticles[J].Journal of applied physics,2006,99(10).materials,2010,22(19):2155-2158.
[7]Jin Z M.Preparation of metal nanoarray materials and their application in surface-enhanced Raman scattering[D].
[8]catalyst-free and catalyst-induced GaN nanowires[J].Nano Res.2010(3):528.8ChèzeCGeelhaar L,Brandt O,et al.Direct comparison of catalyst-free and catalyst-induced GaN nanowires[J.Nano Res.2010(3):528.
[9]Huang CT,Song JH,Lee WF,et al.GaN Nanowire Arrays for High-Output Nanogenerators[J].Am.Chem.Soc.,2010,[J].Applied Physics Letters,2002,81(12):2193-2195.
[11]Lin Z,Xiu X,Zhang S,et al.Arrays of GaN nano-pillars fabricated by nickel nano-island mask[J].Materials Letters,
[12]Nahhas A M.Review of GaN nanostructured based devices Am.J. Nanomater,2018,(1):1-14










