基于干法刻蚀和湿法腐蚀方法的 GaN纳米柱阵列制备研究论文
2025-07-30 16:41:24 来源: 作者:xuling
摘要:研究制备周期有序的高纵横比GaN纳米阵列,有效改善光电器件的光吸收和提取。利用聚苯乙烯胶体球(PS球)和介质掩模刻蚀,四甲基氢氧化铵(TMAH)腐蚀辅助的方法,制备高纵横比的GaN纳米柱阵列。
摘要:研究制备周期有序的高纵横比GaN纳米阵列,有效改善光电器件的光吸收和提取。利用聚苯乙烯胶体球(PS球)和介质掩模刻蚀,四甲基氢氧化铵(TMAH)腐蚀辅助的方法,制备高纵横比的GaN纳米柱阵列。在制备过程中,掩膜层的刻蚀选择比决定纳米柱的高度和形貌,感应耦合等离子体刻蚀(ICP)参数和TMAH腐蚀时间影响纳米柱的形貌。研究了不同掩膜层的选择比、ICP气体流量和种类、TMAH腐蚀时间对纳米柱形貌的影响,优化调整了工艺。扫描电子显微镜(SEM)表征纳米柱形貌,分析表明:(1)PS球、100 nm氮化硅和20 nm镍组合掩膜的选择比最高,制备出直径高度比大于1∶5的高纵横比纳米柱;(2)ICP刻蚀的最佳参数为64 sccm氯气,8 sccm三氯化硼,ICP功率100 W,BIAS功率70 W,腔压0.6 Pa,刻蚀速率约90 nm/min,侧壁倾斜角度约80°;(3)纳米柱的侧壁会随着TMAH的腐蚀时间变得垂直光滑,腐蚀时间不够侧壁呈阶梯状台阶,腐蚀时间过长纳米柱从底部脱落,最佳腐蚀时间为30 min,并从原子结构解释了湿化学腐蚀行为。
关键词:GaN;纳米柱阵列;聚苯乙烯胶体球;刻蚀掩膜;TMAH
0引言
随着纳米制造技术的快速发展,氮化镓基半导体纳米柱的制备和研究因其独特的优势效应在电子和光电子器件中的潜在应用引起了人们的广泛关注[1]。与目前使用的传统薄膜平面结构相比,基于GaN的纳米柱提供了许多潜在的优势。高纵横比和大表面体积比的GaN纳米柱可以显著降低纳米柱上部的位错密度,是调控光反射、散射、透射的一种有效方法,大表面体积能有效地吸收光子,具有更高的量子效率,从而显著提高光电转换效率[2]。对于太阳能电池[3],红外紫外探测器[4]、光电传感器[5]等光电子应用和器件性能的提升有着重要意义。
纳米柱的非平面结构,有望提高光提取效率[6]。通过改变纳米柱的周期、直径、高度和占空比等尺寸,可以获得多色发射,有望通过红绿蓝(RGB)混色实现低成本的单片白光发射[7]。最有希望的是,在核心/壳纳米柱结构中,InGaN/GaN多量子阱(mqw)生长在纳米柱的整个圆柱形表面上,被认为能够有效地将活性面积增加约4n的纵横比,从而增加相同衬底面积的总光强[8]。
制备纳米柱阵列的方法分为“自下而上(bottom-up)”[9]和“自上而下(top-down)”[10]。“自下而上法”是使用分子束外延或金属有机化学气相沉积法[11],在图案化衬底上有选择的生长纳米柱阵列[12];“自上而下法”是通过刻蚀等方法去除纳米柱之外部分,主要包括光刻法、纳米压印法[13]、胶体球刻蚀法[14]等。
制备高纵横比的氮化镓纳米柱阵列有3个挑战,一是实现纳米级别(100~500 nm)尺寸的周期性高纵横比纳米柱的圆形图案化掩膜;二是在刻蚀纳米柱的过程中,尽可能地减少对掩膜的刻蚀(刻蚀氮化镓的速率比刻蚀掩膜的速率快,即刻蚀选择比要高),保证刻蚀掩膜的阻挡作用;三是保持高质量的纳米柱刻蚀形貌,纳米柱刻蚀侧壁垂直且光滑。为解决这些问题,大多数研究都使用了纳米压印结合离子束刻蚀的方法制备纳米柱阵列结构,该方法能成功制备出纳米柱阵列,但是制备成本高,商业化量产的可行性不高。
本文研究了基于纳米球刻蚀的干法刻蚀和湿法腐蚀的方法制备GaN纳米柱阵列,针对制备工艺的三大挑战提出了解决方案,提出了纳米球刻蚀法,对比分析了不同刻蚀掩膜的刻蚀选择比,讨论了不同刻蚀参数和湿法腐蚀时间对纳米柱形貌的影响,利用场发射扫描电子显微镜(SEM)表征GaN纳米柱的形貌[15],实现低成本制备尺寸可控、侧壁垂直、高纵横比的纳米柱阵列结构,为进一步提升光电子器件性能打下基础。
1实验
“自下而上”法制备的纳米柱多是杂乱无章的线,难以实现周期性的阵列结构,且纳米线的尺寸形貌难以调控[16]。因此,本实验采用基于纳米球刻蚀“自上而下”的刻蚀方法制备氮化镓纳米柱阵列结构。
基于聚苯乙烯胶体球和刻蚀掩模层制备GaN纳米柱阵列结构的工艺流程如图1所示。首先,在蓝宝石衬底上使用金属有机化合物化学气相沉淀(MOCVD)外延3μm微米的氮化镓外延层,然后使用丙酮、无水乙醇、超纯水依次超声清洗5 min,去除氮化镓表面的脏污和氧化层。为了提高氮化镓纳米柱刻蚀过程中的选择比(即刻蚀过程中掩膜的刻蚀速率与氮化镓刻蚀速率的比值),首先,在氮化镓表面通过电子束热蒸发蒸镀20 nm金属镍和等离子体化学气相沉积(PECVD)生长100 nm氮化硅刻蚀掩膜层,刻蚀过程中保证纳米柱的高质量形貌。接着将直径300 nm的聚苯乙烯胶体球(Polystyrene,PS)通过气液界面法自组装[16]到生长好外延和刻蚀掩膜层的氮化镓上,PS球阵列实现纳米级的圆形图案化刻蚀掩膜。
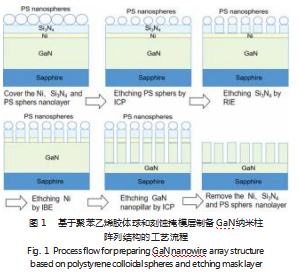
自然干燥后通过电感耦合等离子体刻蚀(Inductively Coupled Plasma,ICP)40 s聚苯乙烯胶体球;反应离子刻蚀(Reactive ion etching,RIE)1 min氮化硅和离子束刻蚀(Ion Beam Etching,IBE)110 s金属镍掩膜层,制备出理想尺寸的刻蚀掩膜层图案,接着使用ICP刻蚀氮化镓纳米柱。将刻蚀好的氮化镓纳米柱放入有机碱四甲基氢氧化铵(TMAH)中腐蚀30 min修饰氮化镓纳米柱侧壁,调控纳米柱直径与侧壁倾斜角度等形貌。最后使用去胶液洗去PS球,缓冲氧化物蚀刻剂(Buffered Oxide Etch,BOE)去除氮化硅掩膜,SPM(H2SO4/H2O2 at 100~130℃)洗去金属镍,干燥后即可获得理想尺寸的高纵横比的氮化镓纳米柱阵列。
2结果与分析
2.1不同刻蚀掩膜层对刻蚀形貌的影响
聚苯乙烯胶体球的成分是碳氢氧的长链结构,能与氧气反应生产一氧化碳、二氧化碳和水[17]。本实验使用的PS胶体球直径为300 nm,通过氧气和氩气刻蚀40 s,修饰后的小球直径更小,其特性决定了PS球在刻蚀的过程中选择比不高,因此,基于PS球掩膜难以实现制备高纵横比的氮化镓纳米柱阵列,只能实现刻蚀高度较小(100~200 nm)的纳米柱阵列,纳米柱直径和高度比约1∶1,刻蚀时间加长,PS球形变掩膜作用减弱,甚至PS球被完全刻蚀,所以制备高纵横比的氮化镓纳米柱形貌严重形变,如图2所示。由图中纳米柱形貌可知,在ICP刻蚀纳米柱的过程中,刻蚀胶体球的速率大于刻蚀氮化镓的速率,刻蚀过程中PS球圆形图案畸变,掩膜作用减弱直至完全丧失,最终制备出的纳米柱阵列严重形变。
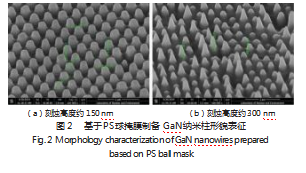
为了实现纳米柱刻蚀过程中的高选择比,保证高质量的刻蚀形貌,在PS球掩膜层与氮化镓外延层中引入不同刻蚀掩膜层,将修饰好的胶体球图案转移到具有更高选择比的掩膜层(如二氧化硅掩膜、氮化硅掩膜、镍掩膜、氮化硅掩膜加镍掩膜),在掩膜层作用下,能够刻蚀出高质量的氮化镓纳米柱阵列。引入不同掩膜层后,ICP刻蚀6 min制备的氮化镓纳米柱形貌表征如图3所示。
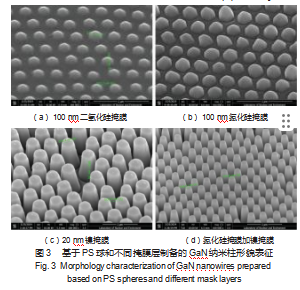
ICP通过氧气和氩气刻蚀40 s PS球,将小球直径修饰约200 nm,然后通过RIE刻蚀110 s二氧化硅,将修饰好的小球图案转移到二氧化硅掩膜层上,从图3(a)的半球形纳米阵列可知小球还未完全形变,所以纳米球图案成功转移到到二氧化硅掩膜上,但在ICP刻蚀GaN时,SiO2和PS球的掩膜作用减弱至消失,最终制备出直径约150 nm,高度约130 nm的半球形GaN阵列,PS小球和SiO2掩膜层刻蚀选择比不高;氮化硅掩膜制备纳米柱的工艺与二氧化硅相似,只是RIE刻蚀100 nm氮化硅的时间为1 min,同样在刻蚀纳米柱过程中,Si3N4和PS球的掩膜作用减弱至消失,最终制备出直径约150 nm,高度约200 nm的半球形GaN阵列,从高度可知Si3N4掩膜的刻蚀选择比稍大于SiO2掩膜,但也难以实现制备;20 nm金属镍加PS球的掩膜制备的纳米柱形貌较好,纳米柱高度约800 nm,金属镍的刻蚀选择比高,掩膜作用强,但是在将PS球自组装的单层掩膜转移到材料金属镍表面时,PS球不易附着在金属镍表面,难以实现大面积的图案化掩膜,不利于制备大面积的纳米柱阵列;图3(d)为PS球加100 nm氮化硅加20 nm金属镍掩膜制备的纳米柱阵列,纳米柱直径约150 nm,高度约800 nm,纳米柱直径和高度的比大于1∶4。因为PS小球容易附着在氮化硅上,金属镍能满足刻蚀选择比,所以PS球加100 nm氮化硅加20 nm金属镍掩膜能实现高纵横比GaN纳米柱制备,而且刻蚀掩膜也能作为后续湿化学腐蚀的掩膜,为后续纳米柱阵列的干法刻蚀和湿法腐蚀工艺奠定了基础。
2.2 ICP刻蚀参数对刻蚀形貌的影响
ICP刻蚀过程中不同的工艺参数会直接影响纳米柱的刻蚀速率和刻蚀形貌,如气体组分、气体流量、腔体压力和刻蚀功率等[18]。对于本文的氮化镓纳米柱阵列结构,气体组分、气体流量和刻蚀功率直接影响刻蚀深度和刻蚀侧壁倾斜角度,因为结构是纳米级的尺寸,较大的倾斜角度会直接使纳米柱下端相连,难以得到理想的高质量纳米柱阵列。ICP刻蚀分为物理刻蚀作用和化学刻蚀作用,不同气体与不同比例流量直接决定刻蚀中哪种刻蚀起主要作用,本文研究分析了不同气体组分和不同比例气体流量对纳米柱刻蚀的影响,氮化镓纳米柱形貌表征如图4所示,确定了最优的ICP刻蚀工艺。
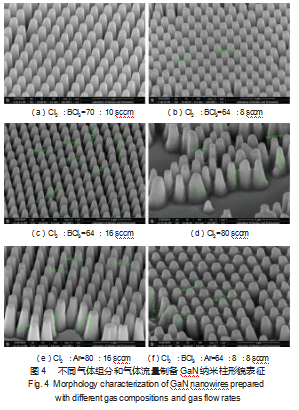
由图可知,纳米柱形貌最佳的为图4(b),ICP刻蚀GaN纳米柱的最佳工艺参数为64 sccm氯气和8 sccm三氯化硼,ICP功率为100 W,BIAS功率为70 W,腔压为0.6 Pa,刻蚀速率约为90 nm/min,侧壁倾斜角度约80°。图4(a)~(c)为不同气体流量刻蚀的纳米柱,图4(a)刻蚀速率为97 nm/min,图4(c)刻蚀速率为80 nm/min,在一定范围内,刻蚀功率一定的情况下,气体流量等比例增加,电离的等离子体相应增加,等离子体密度增大,化学刻蚀作用增强,所以刻蚀速率更快,对掩膜的刻蚀也更快,造成纳米柱上端直径减小,侧壁倾斜角度增大;图4(d)单独使用氯气的刻蚀,主要化学作用刻蚀,部分氯气未能及时电离成等离子体,未电离的气体充当“保护气体”,物理离子轰击作用很弱,从而刻蚀速率减慢。图4(e)加入氩气,增加了物理轰击刻蚀作用,氩气增加了对PS小球的刻蚀,所以制备的GaN纳米柱上端直径最小约100 nm;图4(f)未电离的“保护气体”较多,所以刻蚀速率最慢,约35 nm/min。
2.3 TMAH湿法腐蚀时间对氮化镓纳米柱形貌的影响
ICP干法蚀刻制备的GaN纳米柱阵列通常存在表面粗糙、陡峭度差以及在干法蚀刻过程中离子轰击和掩膜侵蚀导致的缺陷。这些缺陷会造成光散射造成的光损耗和表面非辐射复合造成的载流子注入损耗,从而影响器件性能和可靠性[19]。为了解决这些问题,有必要开发一种有效的湿化学技术来抛光蚀刻面。本文研究了干法蚀刻形成的氮化镓侧壁面湿法化学抛光工艺,以消除蚀刻损伤,使垂直侧壁光滑,将湿化学抛光技术与干刻蚀技术相结合。
众所周知,GaN可以与氢氧离子(OH−)反应生成GaOx,GaOx可以溶解在碱性溶液中[20]。在ICP刻蚀后,常将氢氧化钾溶液应用于GaN湿化学刻蚀。然而,KOH是一种强碱,即使在低温下也会在平面GaN表面产生三角形蚀刻坑,这可能会增加器件光损耗,从而影响量子效率,与KOH溶液相比,四甲基氢氧化铵(TMAH)是一种有机碱,具有更稳定的蚀刻过程[21]。因此,TMAH是抛光蚀刻面的有希望的候选材料。
在这项工作中,详细研究了80℃的TMAH溶液湿法化学蚀刻不同时间的GaN纳米柱干法刻蚀面侧壁的形态演变,如图5所示。此外,提出了一个简单的原子模型来解释氮化镓侧壁的湿化学蚀刻行为。通过控制TMAH湿化学蚀刻的时间实现调控纳米柱尺寸和抛光刻蚀侧壁。
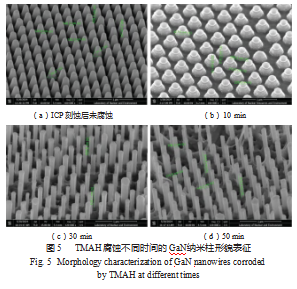
ICP刻蚀制备的GaN纳米柱难以实现刻蚀侧壁倾斜角垂直且光滑,如图5(a)所示;以PS球和刻蚀掩膜为湿化学腐蚀的掩膜,TMAH溶液能腐蚀纳米柱刻蚀侧壁,腐蚀10 min的纳米柱形貌如图5(b)所示,纳米柱侧壁成阶梯状台阶,说明纳米柱侧壁是从上到下腐蚀的,上端已经被腐蚀掉了,下端还未完全腐蚀,腐蚀时间不够;图5(c)是腐蚀30 min的纳米柱形貌,侧壁垂直且光滑;图5(d)的纳米柱侧壁也是垂直且光滑,但是出现个别纳米柱腐蚀脱落的情况,说明50 min腐蚀时间过长;TMAH腐蚀30 min最佳。
TMAH湿法化学蚀刻过程中GaN侧壁的原子结构,首先,未被掩膜覆盖的表面Ga原子和具有带正电悬空键的Ga原子在TMAH碱性溶液中与OH-相互吸引并发生反应,形成GaOx。然后GaOx溶解在TMAH碱性溶液中,其次,侧壁表面的Ga原子暴露在溶液中,可以受到来自侧壁表面的OH−的攻击。Ga原子上下的N原子也会被移走。在掩膜边缘正下方位置的N原子,具有两个带负电荷的悬空键,可能与掩膜形成一种键[22]。这些固定在掩膜边缘的N原子对OH-形成强大的排斥力,阻止它们攻击Ga原子。因此,湿法蚀刻在掩模边缘处停止。
3结束语
本文研究了基于纳米球刻蚀的干法刻蚀和湿法腐蚀低成本制备高纵横比氮化镓纳米柱的方法,在聚苯乙烯胶体球图案化的基础上,研究了不同刻蚀掩膜层的刻蚀选择比,对氮化镓纳米柱刻蚀形貌的影响,确定了PS小球、100 nm氮化硅和20 nm金属镍组合掩膜层为最佳刻蚀掩膜;并分析了不同ICP参数对纳米柱刻蚀形貌的影响,给出了优化后的刻蚀参数为64 sccm氯气和8sccm三氯化硼,ICP功率为100 W,BIAS功率为70 W,腔压为0.6 Pa,刻蚀速率为90 nm/min,侧壁倾斜角度约80°。对刻蚀后的氮化镓纳米柱湿化学刻蚀,研究了湿法腐蚀的机理,对比了不同腐蚀时间对纳米柱尺寸形貌的影响,确定了湿法腐蚀最优时间是30 min。对制备具有高纵横比的氮化镓纳米柱阵列结构的三大挑战,给出了较为合理的解决方案,成功制备出高质量的高纵横比氮化镓纳米柱阵列结构,研究结果为寻找低成本制备具有高纵横比的周期性紧密排列的氮化镓纳米结构阵列提供了方法,为进一步改善光电器件性能打下基础。
参考文献:
[1]Yan O,Kong P,Qian J,et al.Fabrication of three-dimensional mi⁃crostructures on GaN surfaces through the integration of femto⁃second laser ablation and ICP etching[J].Optics Communica⁃tions,2024,569:130822-130822.
[2]Reddy N P,Naureen S,Mokkapati S,et al.Enhanced lumines⁃cence from GaN nanopillar arrays fabricated using a top-down process[J].Nanotechnology,2016,27(6):065304.
[3]Tan X,He Z,Li W,et al.Low-Cost Preparation of Diamond Nano⁃pillar Arrays Based on Polystyrene Spheres[J].ACS omega,2024,9(25):27492-27498.
[4]Kim J H,Yim H J,Kim H,et al.Fluorine-Based Low-Damage Se⁃lective Etching Process for E-Mode p-GaN/AlGaN/GaN HFET Fabrication[J].Electronics,2023,12(20).
[5]谢婷,冯林,杨丽艳,等.基于PS球自组装技术的GaN纳米柱阵列ICP刻蚀工艺研究[J].机电工程技术,2024,53(4):273-277.
XIE T,FENG L,YANG L Y,et al.Research on ICP etching pro⁃cess of GaN nanopillar array based on ps sphere self-assembly technology[J].Mechanical&Electrical Engineering Technology,2024,53(4):273-277.
[6]刘双飞,肖家军,张蓓,等.基于纳米压印技术的GaAs纳米柱阵列ICP刻蚀工艺及其光学特性研究[J].电子测试,2022,36(10):39-41.
LIU S F,XIAO J J,ZHANG B,et al.Research on inductively cou⁃pled plasma etching process and optical properties of GaAs nano⁃pillar array based on nanoimprint technology[J].Electronic Test,2022,36(10):39-41.
[7]唐寅.基于胶体球印刷术的纳米粒子光学超表面制造技术研究[D].上海:东华大学,2023.
[8]邓国伟,王佳乐.利用聚苯乙烯纳米球刻蚀法制备周期有序δ-MnO_2纳米阵列[J].东华大学学报(自然科学版),2023,49(5):41-46.
DENG G W,WANG J L.Fabrication of periodically orderedδ-MnO_2 nanoarrays by polystyrene nanosphere etching[J].Journal of Donghua University(Natural Science),2023,49(5):41-46.
[9]Sayago I,Hontañón E,Aleixandre M.Preparation of tin oxide nanostructures by chemical vapor deposition[J].Tin Oxide Mate⁃rials,2020:247-280.
[10]Lin Y T,Yeh T W,Nakajima Y,et al.Catalyst⁃free GaN nanorods synthesized by selective area growth[J].Advanced Functional Materials,2014,24(21):3162-3171.
[11]Shamim M A,Istiaq A M A,Tasmima A,et al.Light Ex-trac⁃tion Efficiency Enhancement of White Organic Light-Emitting Diodes(OLEDs)by Mi-cro/Nano-Patterning the Substrate Layer[J].Defect and Dif-fusion Forum,2024,43285-106.
[12]冒小康.GaN微米柱的制备及其光学特性研究[D].南京:南京大学,2021.
[13]康云龙,刘君哲,尹耀龙.大规模GaN纳米线阵列的制备及表征[J].广东化工,2018,45(14):19-21.
KANG Y L,LIU J Z,YIN Y L.Synthesis and characterization of large scale GaN nanowire arrays[J].Guangdong Chemical Indus⁃try,2018,45(14):19-21.
[14]林小艺.ICP刻蚀在GaAs,GaN及SiC器件制备中的研究[D].厦门:厦门大学,2021.
[15]Jianqi D,Dongqi Z,Yi M,et al.Plasmon-enhanced self-powered GaN/ZnTe core/shell nanopillar array pho-todetector[J].Nano Research,2024,17(6):5569-5577.
[16]曾梦丝,彭新村.GaAs纳米线阵列光阴极的制备及其特性研究[J].光学仪器,2018,40(1):67-71.
ZENG M S,PENG X C.Preparation and characterization of GaAs nanowire array photocathode[J].Optical Instruments,2018,40(1):67-71.
[17]祁琦.基于PS球自组装技术的微纳结构制备及SERS应用[D].北京:北方工业大学,2020.
[18]钱茹,程新红,郑理,等.p-GaN在不同掩膜和刻蚀气体中的ICP刻蚀[J].半导体技术,2018,43(6):449-455.
QIAN R,CHENG X H,ZHENG L,et al.Inductively coupled plasma etching of p-GaN using different masks and etching gas⁃es[J].Semiconductor Technology,2018,43(6):449-455.
[19]王淼.基于氮化镓基光电子器件的微纳结构光场调控[D].合肥:中国科学技术大学,2022.
[20]Jaloustre L,De Mello S S,Labau S,et al.Faceting me-chanisms of GaN nanopillar under KOH wet etching[J].Materials Science in Semiconductor Processing,2024,173:108095.
[21]孙卫华,韩建强,徐宇翔,等.KOH和TMAH基腐蚀液中凸角补偿结构的研究[J].中国计量大学学报,2023,34(3):421-428.SUN W H,HAN J Q,XU Y X,et al.Study on the convex corner compensation structures in the etching solutions based on KOH and TMAH[J].Journal of China University of Metrology,2023,34(3):421-428.
[22]Hu N,Fujisawa T,Kojima T,et al.Improved performance of In⁃GaN/GaN multiple-quantum-wells photovoltaic de-vices on free-standing GaN substrates with TMAH treat-ment[J].Solar Energy Materials and Solar Cells,2024,275:113025-113025.










