外延生长对GaN基PIN型器件的影响研究论文
2024-05-29 15:28:19 来源: 作者:caixiaona
摘要:实现了 PIN 型 GaN 外延材料的生长, 并深入研究了影响器件性能的关键 i-GaN 外延层的生长温度和生长气流等要素。结果表 明, 适当的生长温度和气流条能够有效改善 GaN 的位错密度和背景掺杂, 从而提升其晶体质量; 过高或过低的生长温度和低气流 则可能导致杂质原子如 C 、O 等并入外延材料, 形成高位错和缺陷。制备了GaN 基 PIN 型器件, 并探究了不同p 层掺杂浓度对其电 学 I-V 特性的影响。结果表明, 较高的掺杂浓度有助于制备势垒低的欧姆接触, 形成更优越的 PN 结特性。比较了
摘要:实现了PIN型GaN外延材料的生长,并深入研究了影响器件性能的关键i-GaN外延层的生长温度和生长气流等要素。结果表明,适当的生长温度和气流条能够有效改善GaN的位错密度和背景掺杂,从而提升其晶体质量;过高或过低的生长温度和低气流则可能导致杂质原子如C、O等并入外延材料,形成高位错和缺陷。制备了GaN基PIN型器件,并探究了不同p层掺杂浓度对其电学I-V特性的影响。结果表明,较高的掺杂浓度有助于制备势垒低的欧姆接触,形成更优越的PN结特性。比较了Ni/Cr和Ni/Au两种金属接触对器件I-V特性的影响。结果表明,以Ni/Au制备P型欧姆接触能够获得更低的反向漏电流。此外,相较于Cr、Au具有更优越的稳定性和耐压性。深入探讨了PIN型GaN外延材料的生长条件对器件性能的影响,并通过制备GaN基PIN型器件深入研究了掺杂浓度和金属接触对电学特性的影响。
关键词:GaN;PIN;生长温度和气流;p层掺杂浓度;欧姆接触;漏电流
0引言
近几十年来,半导体技术的发展推动了电子器件领域的长足进步。第一代半导体硅(Si)奠定了电子器件的基础,但在高频、高压、强辐射条件下表现出不足。第二代半导体以砷化镓(GaAs)为代表,广泛应用于4G通信等领域,但同样面临性能限制。随着科技不断进步,第三代半导体以氮化镓(GaN)为代表崭露头角,具备高电子饱和迁移率、高击穿电场、高热导率等特性[1],为电子器件的发展提供了新的机遇。目前,GaN已广泛应用于高电子迁移率晶体管(HEMT)、异质结双极晶体管(HBT)、发光二极管(LED)、激光二极管(LD)和紫外(UV)探测器等微电子和光电子器件领域[2-4],为行业带来了新的发展机遇。
在照明领域,氮化镓(GaN)薄膜的高质量生长已经取得显著的进展。1993年,Akasak等[5]首次成功制备出了P-GaN/n-InGaN/n-GaN双异质结构蓝光发光二极管(LED)。在室温下,正向电流为20 mA时,输出功率为125μW,外部量子效率高达0.22%。蓝光LED的出现解决了合成白光的难题,对LED的全彩显示和可见光照明产生了革命性的影响。在半导体器件领域,GaN材料广泛用于高电子迁移率晶体管(HEMT)。目前,主流的制备方法是通过异质衬底外延生长GaN薄膜。由于存在极化效应,异质结之间形成了高浓度的二维电子气(2DEG)。这种二维电子气显著提升了GaN薄膜的电子迁移率和饱和电子漂移速率。早在1993年,M A Khan等[6]利用二维电子气成功开发出了饱和电子漂移速率为1×107 cm/s,电子迁移率为2 000 cm2/V·s的AlGaN/GaN结构的HEMT。在2007年,王晓亮等[7]在50 mm半绝缘6H-SiC衬底上生长的AlGaN/GaN HEMT中,其二维电子气迁移率高达2 215 cm2/V·s,二维电子气浓度更是达到了1.044×1 013 cm-2。
与此同时,由于GaN具有禁带宽度大、位移能高等特点,并且随着器件制备工艺的逐渐成熟,GaN在核辐射探测领域表现出越来越显著的优越性。目前,大多数GaN核辐射探测器采用同质衬底的三明治结构。尽管这类探测器在探测性能上表现出色,但自支撑衬底的高昂成本和相对较小的尺寸限制了GaN探测器在产业应用上的发展。早期GaN发展受限于缺乏同质衬底,直到1969年,Maryska等[8]在Sapphire衬底上采用氢化物气相外延(HVPE)成功获取了载流子浓度在(1~5)×1019 cm-3的单晶GaN,其载流子迁移率为125~150 cm2/V·s。随后,Yoshida等[9]通过研究反应分子束(MBE)在AlN涂层蓝宝石上生长的GaN外延薄膜的电学和发光性能中,证实了AlN外延薄膜上的GaN薄膜具有更大的霍尔迁移率并且使用AIN涂层蓝宝石作为衬底可以提高GaN薄膜的晶体质量。Amano等[10]使用低温AlN两步外延的方法并结合金属有机化学气相沉积(MOCVD)技术成功生长出光学表面平坦无裂纹的GaN薄膜。由于MOCVD生长技术的独特优势和不断完善发展,研究者们逐渐将注意力转向基于蓝宝石衬底的GaN外延层。此外,相对于其他半导体器件的肖特基结构,PIN型结构的器件具有更高的内建电场和势垒,在探测器等器件中具备更大的优势。因此,如何实现高质量的PIN型GaN外延层的生长成为当前研究的焦点。
本文采用金属有机化学气相沉积(MOCVD)技术在蓝宝石衬底上生长PIN型GaN外延薄膜,为提高PIN型GaN外延材料的晶体质量,对PIN型中关键i-GaN外延层的生长温度以及生长气流等生长要素进行研究。同时讨论了P-GaN中掺杂浓度对器件I-V特性的影响以及不同金属接触对于器件性能的变化。
1实验
实验中GaN样品采用金属有机化合物气相沉积(MOCVD)在c向蓝宝石平面衬底上生长,生长过程中使用低温GaN成核层的GaN的两步外延生长工艺[11]。以TMG和NH3为源,先生长出低温成核层,再生长高温外延层,在生长n型以及P型GaN时分别采用SiH4(Si掺杂)和Cp2Mg(Mg掺杂)作为掺杂剂。在蓝宝石衬底上先生长2μm的u-GaN作为缓冲层用以减小应力,再分别生长2μm的n-GaN层和i-GaN层,而后在其上生长300 nm的p-GaN层并进行炉内N2活化,最终形成PIN型GaN外延材料薄膜。其化学反应方程如下:
Ga(CH3)3(g)+NH3(g)→GaN(s)+3CH4(g)(1)为了制备出PIN型器件,使用感应耦合等离子体
(ICP)刻蚀形成台面,再经过电子束蒸镀N型GaN欧姆接触电极和P型金属欧姆电极。结构示意如图1所示,方形P电极为2 mm×2 mm,环状n电极宽度为0.5 mm。
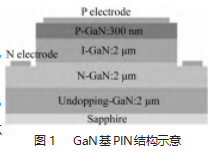
同时,为生长出晶体质量较高的PIN型GaN外延材料以及改善PIN型器件性能,对其关键的i-GaN外延层生长过程中的生长温度、生长气流进行大量研究。此外,为改善器件性能,深入研究了PIN型中p-GaN层的掺杂浓度变化对P型欧姆电极的影响,并且对比了P型金属欧姆电极,研究了Ni/Cr(50/50 nm)和Ni/Au(50/50 nm)对器件I-V特性的影响。
2结果与讨论
2.1生长温度、气流对GaN外延层的影响
由于缺乏与GaN晶格常数和热膨胀系数相匹配的衬底材料,导致生长出的GaN外延薄膜位错密度相对较高。而低温两步外延生长法能够有效降低外延测的位错密度[12-13]。这种方法引入的低温成核层即为后续高温外延GaN薄膜生长提供了一维的成核点,而后这些成核点继续在横向和纵向生长,最终形成了连续的二维薄膜,又能有助于释放GaN薄膜和衬底之间的应力,导致大量位错集中在衬底和外延薄膜的界面处,从而在随后的高温生长过程中降低位错密度[14]。此外,对于PIN型器件,i层既是空间电荷区,也是耗尽层。过高的位错密度以及过高的背景掺杂都会致使器件性能变差。因此,i层的晶体品质是决定整个器件性能的重要因素,而其生长过程会受到生长温度、气流等因素的影响[15-16]。对此,研究以下因素对GaN晶体质量的影响。
(1)生长温度
为研究生长温度对u-GaN晶体质量的影响,以三甲基镓(TMGa)和氨气(NH3)为源。其中,TMGa的流量为34.7 sccm(即cm3/min),NH3为4 slm(即l/min),反应室为常压水平反应室,Ⅴ/Ⅲ比为1 791.5。生长温度为1 075~1 165℃,生长了7组样品,材料表征方式采用X射线衍射(XRD)技术进行晶体质量评估。同时,由于生长温度不同,生长速会发生相应变化,因而会造成XRD的测量误差。为避免由于不同厚度导致的测量误差,将所有样品的生长厚度控制在约为3.6μm。生长参数以及测试结构如表1、图2所示。

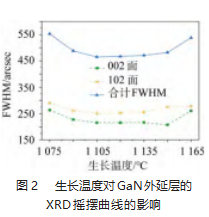
图2所示为生长温度对GaN外延层的X射线摇摆曲线的影响,随着生长温度的上升,GaN的外延材料晶体质量先有所好转后又逐渐恶化。当温度升高时,杂质O是主要剩余施主,升高温度则有利于抑制
O杂质的并入。O可能来源于TMGa或NH3,也可能来自生长系统的沾污或漏气。但随着生长温度的继续升高,无论是剩余施主杂质还是剩余受主杂质的浓度均有所提高[17]。剩余受主杂质主要是C,它主要是来自TMGa的热解所产生的甲基。甲基既可能占据Ga位,失去H掺入外延层;又可能和H结合,生成CH4从表面脱附。这两种机制竞争的结果使得GaN中的C含量随着温度的升高而上升。从而随着背景掺杂的浓度的上升,位错密度增加,外延层GaN的XRD半高宽增加,晶体质量变差。
(2)生长气流
如今MOCVD设备反应室气流都是层流系统,这样设计既可以使MO源与气流源充分混合,也能避免形成涡流现象。因此一般分为3层流,分别为V族气流(GS-Total)、Ⅲ族气流(MO-Total)、吹扫气流(OT-Total)。为研究生长气流对u-GaN晶体质量的影响,保持TMGa为34.7 sccm和NH3为4 slm,Ⅴ/Ⅲ比为1 791.5不变。3层气流分别为10-10-34 slm,11-11-34 slm作为对照组,保持GS-Tota和MO-Total一致,也可避免切换气流时导致回流。生长参数如表2所示。

图3所示为出生长气流对GaN外延层的X射线摇摆曲线的影响。
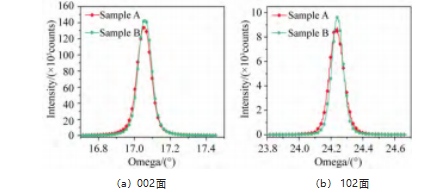
其中A样品的002面和102面的FWHM分别为332 arcsec及377 arcsec。而B样品002面、102面的FWHM分别下降至317 arcsec及312 arcsec。可见随着气流的增大从而提高了反应室的工作压力,致使Ⅴ/Ⅲ族源的分压增大,进而减少了C、O等非故意掺杂杂质的并入,减少了GaN的晶体位错并且提高了GaN的晶体质量。同时总气流增大又稀释了反应剂使生长速度下降,提升了外延片的均匀性。如图4所示,所测得两个样品的方块电阻(Rs)也可印证随生长气流的增大,背景杂质浓度下降,从而提升了样品B的Rs值。

图5所示为样品B所测SIMS。
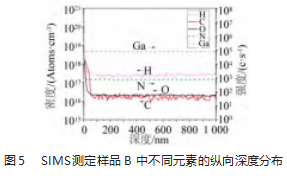
2.2 P-GaN及其欧姆接触对PIN型器件的影响
(1)P型掺杂
为研究P型掺杂(Mg掺杂)对PIN型器件电学特性的影响,生长出了外延层整体厚度约为6μm,其中2μm缓冲层,n层和i层各2μm,p层300 nm,n层掺杂浓度约为1019 cm-3。为了对比p层掺杂浓度(Mg掺杂)对PIN型器件的影响,采用Cp2Mg作为掺杂剂生长出掺杂浓度分别约为1020 cm-3(Hall测试出空穴浓度约为1017 cm-3)和1017 cm-3的2个样品Ⅰ、Ⅱ。
图6所示为其电学I-V特性。由图可知,高掺杂的p层显著的增强了GaN基PIN型器件的电学特性。当金属与半导体接触时,如果半导体掺杂浓度很高,则势垒区宽度变得很薄,电子也要通过隧道效应贯穿势垒产生相当大的隧道电流,甚至超过热电子发射电流而成为电流的主要成分。当隧道电流占主导地位时,它的接触电阻可以很小,可以用作欧姆接触。因此,半导体重掺杂时,它与金属的接触可以形成接近理想的欧姆接触。高浓度掺杂p层相对于GaN基PIN型和探测器而言,其更低的反向漏电流对于探测器的工作性能也具有十分重要的影响。
(2)P型金属接触
为研究P型金属欧姆电极对GaN基PIN型器件的影响,采用电子书蒸发技术蒸镀Ni/Cr(50/50 nm)和Ni/Au(50/50 nm)2种P型金属欧姆接触样品,分别为样品a、b。对于P-GaN,其功函数高达6.6 eV[18-19],常见的金属功函数都比这个值低,如Pt、Pd等,很难形成良好的欧姆接触。之所以选择Ni作为第一层,是其在氧气氛围退火下,易形成P型NiO[20],P-NiO降低了P-GaN的势垒。
图7所示为不同P型金属欧姆接触电极对PIN型器件的I-V特性。可见相较于Ni/Cr,Ni/Au更具有优势。Sample b比Sample a具有更低的反向漏电流,且耐压性更好。Sample a甚至在-50 V时,其反向漏电达到了10-4数量级。上一层的Au既可以阻止下层的Ni向上扩散[21],而且相较于Cr更为稳定,不易向下扩散,同时还能保护下层的金属免受氧化[22]。
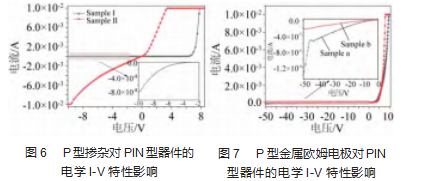
3结束语
本研究通过金属有机化学气相沉积(MOCVD)技术成功生长出高质量的PIN型外延薄膜,并对其i-GaN中的生长过程中的生长温度、气流等关键要素进行深入研究。这为后续制备器件提供了充分的准备。实验结果表明,适当的生长温度和气流对提高PIN型外延薄膜的晶体质量至关重要。过高的生长温度导致大量位错形成,而较低的生长气流会导致非故意杂质原子(如C、O)并入,影响晶体质量。相较于10-10-34 slm气流的生长条件,11-11-34 slm气流的应用显著提高了GaN薄膜的晶体质量和减少了背景杂质。在微电子加工工艺方面,本文成功制备了GaN基PIN结构的器件,并详细讨论了不同P-GaN掺杂浓度以及P型金属欧姆接触对器件特性的影响。实验结果显示,较高的P-GaN掺杂浓度有助于制备低势垒的欧姆接触,并显著提升了器件的PN结特性和耐压性。这一发现对于优化器件性能具有重要意义,为实际应用提供了有益的参考。
在器件制备过程中,比较了2种P型欧姆接触材料(Ni/Cr和Ni/Au)对器件性能的影响。测试结果表明,使用Ni/Au制备的P型欧姆接触明显降低了器件的反向漏电流,达到了1个数量级的改善。此外,Ni/Au接触还表现出更好的稳定性,为器件的长期可靠性提供了保障。
总的来说,本研究通过综合应用MOCVD技术、微电子加工工艺和电学性能测试,深入研究了PIN型GaN外延材料的生长机制和器件性能的优化。本文提出了适宜的生长条件,探讨了掺杂浓度和金属接触材料对器件性能的影响,并为优化PIN型GaN器件设计提供了实用建议。这些研究成果对GaN材料和器件的研究具有重要的理论和实际价值,而且为相关领域的发展提供了实用性的指导和启示。未来,可以在这一基础上进一步拓展研究,推动GaN技术在微电子、光电子等领域的广泛应用。
参考文献:
[1]Strite S,MorkoçH.GaN,AlN,and InN:a review[J].Journal of Vacuum Science&Technology B:Microelectronics and Nanome-ter Structures Processing,Measurement,and Phenomena,1992,10(4):1237-1266.
[2]SHCHEKIN O B,EPLER J E,TROTTIER T A,et al.High per-formance thin-film flip-chip InGaN–GaN light-emitting diodes[J].Applied Physics Letters,2006,89(7):071109.
[3]NAKAMURA S,SENOH M,NAGAHAMA S I,et al.Continuous-wave operation of InGaN/GaN/AlGaN-based laser diodes grown on GaN substrates[J].Applied Physics Letters,1998,72(16):2014-2016.
[4]MAZZEO G,CONTE G,REVERCHON J L,et al.Deep ultravio-let detection dynamics of AlGaN based devices[J].Applied Phys-ics Letters,2006,89(22):223513.
[5]NAKAMURA S,SENOH M,MUKAI T.P-GaN/N-InGaN/N-GaN double-heterostructure blue-light-emitting diodes[J].Japa-nese Journal of Applied Physics,1993,32:L8-L11.
[6]ASIF KHAN M,BHATTARAI A,KUZNIA J N,et al.High elec-tron mobility transistor based on a GaN-AlxGa1–i>xN hetero-junction[J].Applied Physics Letters,1993,63(9):1214-1215.
[7]WANG X L,HU G X,MA Z Y,et al.AlGaN/AlN/GaN/SiC HEMT structure with high mobility GaN thin layer as channel grown by MOCVD[J].Journal of Crystal Growth,2007,298:835-839.
[8]MARUSKA H P,TIETJEN J J.The preparation and properties of vapor-deposited single-crystal-line Gan[J].Applied Physics Letters,1969,15(10):327-329.
[9]YOSHIDA S,MISAWA S,GONDA S.Improvements on the elec-trical and luminescent properties of reactive molecular beam epi-taxially grown GaN films by using AlN-coated sapphire sub-strates[J].Applied Physics Letters,1983,42(5):427-429.
[10]AMANO H,SAWAKI N,AKASAKI I,et al.Metalorganic vapor phase epitaxial growth of a high quality GaN film using an AlN buffer layer[J].Applied Physics Letters,1986,48(5):353-355.
[11]陆大成,段树坤.金属有机化合物气相外延基础及应用[M].北京:科学出版社,2009.
[12]杜大超,林志宇,马俊彩,等.成核层温度对N面GaN外延薄膜质量的影响[C]//全国化合物半导体材料,微波器件和光电器件学术会议.中国电子学会,2010.










